



Schleifen und Polieren von Siliziumkarbid-Substraten
JIZHI Electronics - Schleifen und Polieren von Siliziumkarbid - Polieren von Halbleiterwafern
Siliziumkarbid-Schleifschlämme / Siliziumkarbid-Polierschlämme / Siliziumkarbid (SiC) Läppkissen / SiC-Endpolierkissen
Wesentliche Merkmale
- Heimische Alternativen zu Politex und FUJIBO Polierpads
Produktname
JIZHI Electronics - Schleifen und Polieren von Siliziumkarbid - Polieren von Halbleiterwafern
Produktmerkmale
JIZHI Electronics hat ein vierstufiges SiC-Polierverfahren entwickelt, bei dem verschiedene Qualitäten von Schleifschlämmen, Polierschlämmen und Polierpads (Grobschleifpad, Feinschleifpad, Grobpolierpad und Endpolierpad) kombiniert werden. Dieses Verfahren verbessert die Oberflächenqualität von Siliziumkarbidsubstraten bei Schleif- und Polieranwendungen und erhöht gleichzeitig die Materialabtragsrate erheblich.
Verfahren und Anwendungen
Geeignet für DMP- und CMP-Verfahren für SiC-Siliciumcarbid-Substrate, wodurch Effizienz und Ausbeute effektiv verbessert werden. Die Siliziumkarbid-Polierschlämme und -Polierpads ermöglichen den Ersatz von importierten Produkten vor Ort (im Inland).
Kurzer Überblick über den Verarbeitungsprozess von Siliziumkarbid-Substraten
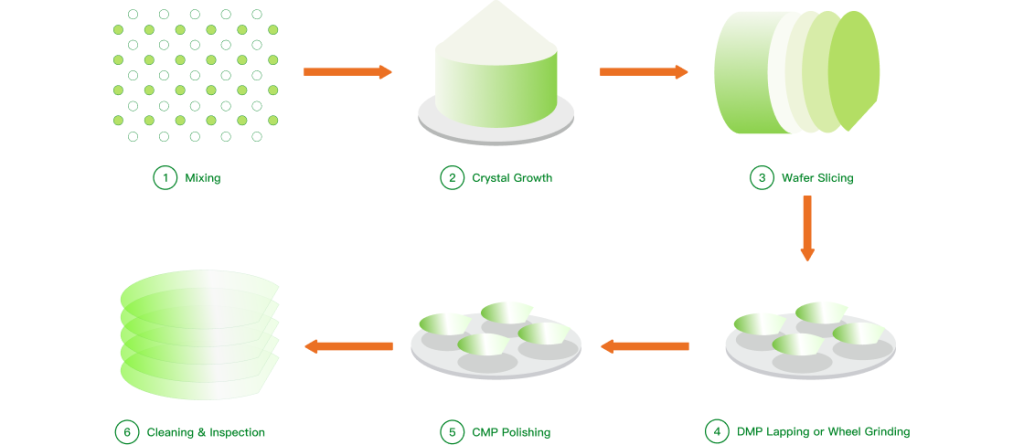
Siliziumkarbid (SiC) Schleifprozess - Grobschleifen / Feinschleifen
Stufe1
JIZHI Electronics Siliziumkarbid (SiC) Grobschleifverfahren
| SiC Beidseitiges Grobschleifverfahren | |
|---|---|
| Ausrüstung für die Verifizierung | 双面36B |
| Wafer | 6″SiC |
| Polierschlämme | JZ-8003 |
| Polierkissen | JZ-1020 |
| Druck | 3 psi |
| Rotationsgeschwindigkeit der oberen Walze | 25 Umdrehungen pro Minute |
| Rotationsgeschwindigkeit der unteren Platte | 10 Umdrehungen pro Minute |
| Durchsatz der Gülle | 5L /min |
| Polierrate | 25-30um/H |
| Oberflächenrauhigkeit | 1,22nm |
| TTV (Total Thickness Variation) | <2 |
| Warp | <30 |
| Bogen | <10 |

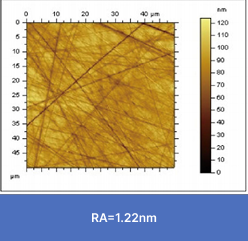
| Grobschleifen - Verwendung mit Läppkissen | |
|---|---|
| Abmessungen und Spezifikationen der Läppscheibe | |
| Modell | JZ-1020 |
| Dicke | 1,4 mm |
| Rillenmuster | Anpassbar |
| Härte | Shore A 85° |
| Verdichtungsverhältnis | 2.92 |

Stufe2
JIZHI Electronics Siliziumkarbid (SiC) Feinschleifverfahren
| SiC Beidseitiges Grobschleifverfahren | |
|---|---|
| Ausrüstung für die Verifizierung | 双面36B |
| Wafer | 6″SiC |
| Polierschlämme | JZ-8001 |
| Polierkissen | JZ-1020 |
| Druck | 3 psi |
| Rotationsgeschwindigkeit der oberen Walze | 25 Umdrehungen pro Minute |
| Rotationsgeschwindigkeit der unteren Platte | 10 Umdrehungen pro Minute |
| Durchsatz der Gülle | 5L /min |
| Polierrate | 6,8 um/H |
| Oberflächenrauhigkeit | 0,45nm |
| TTV (Total Thickness Variation) | <2 |
| Warp | <30 |
| Bogen | <20 |

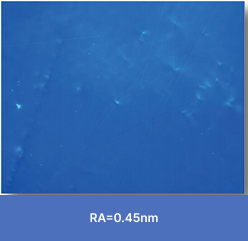
| ine Schleifen - verwendet mit Läppscheibe | |
|---|---|
| Abmessungen und Spezifikationen der Läppscheibe | |
| Modell | JZ-1020 |
| Dicke | 1,4 mm |
| Rillenmuster | Anpassbar |
| Härte | Shore A 85° |
| Verdichtungsverhältnis | 2.92 |

JIZHI Electronics’ CMP Grob- und Feinschleifverfahren für SiC-Substrate
Tipp 1 - Bei Verwendung einer groben Schleifsuspension mit einem Läppkissen kann Ra 1,22 nm oder weniger erreichen.
Tipp 2 - Bei Verwendung einer feinen Schleifsuspension mit einem Läppkissen kann Ra 0,45 nm oder weniger erreichen.
Siliziumkarbid (SiC) Polierverfahren - Grobpolieren / Feinpolieren
Stufe 3
JIZHI Electronics Siliziumkarbid (SiC) Grobpolierverfahren
| CMP-Grobpolierverfahren für SiC-Substrate | |
|---|---|
| Ausrüstung für die Verifizierung | 双面36B |
| Wafer | 6″SiC |
| Polierschlämme | JZ-8010 |
| Polierkissen | JZ-3020 |
| Druck | 350g/cm2 |
| Rotationsgeschwindigkeit | 40 Umdrehungen pro Minute |
| Polierrate | 2,5um/H |
| Oberflächenrauhigkeit | 0,13nm |

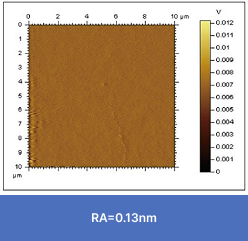
| Abmessungen und Spezifikationen des Grobpolierpads | |
|---|---|
| Modell | JZ-3020 |
| Dicke | 1,4 mm |
| Rillenmuster | Anpassbar |
| Härte | Shore A 85° |
| Verdichtungsverhältnis | 2.94 |

Stufe4
JIZHI Electronics Siliziumkarbid (SiC) Endpolierverfahren
| CMP-Grobpolierverfahren für SiC-Substrate | |
|---|---|
| Ausrüstung für die Verifizierung | 双面36B |
| Wafer | 6″SiC |
| Polierschlämme | JZ-8020 |
| Polierkissen | JZ-326 |
| Druck | 300g/cm2 |
| Rotationsgeschwindigkeit | 40 Umdrehungen pro Minute |
| Polierrate | 0,25 um/H |
| Oberflächenrauhigkeit | 0,06nm |

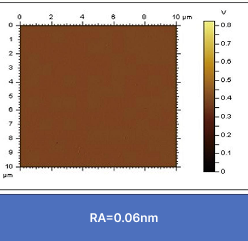
| Abmessungen und Spezifikationen des Grobpolierpads | |
|---|---|
| Modell | JZ-326 |
| Dicke | 1,3 mm |
| Rillenmuster | Anpassbar |
| Härte | Shore A 51° |
| Verdichtungsverhältnis | 10.77 |

JIZHI Electronics’ CMP-Vor- und Endpolierverfahren für SiC-Substrate
Tipp 3 - Bei der Verwendung von grobem Polierschlamm mit einem Läppkissen kann Ra 0,13 nm oder weniger erreichen.
Tipp 4 - Mit einer Endpolierflüssigkeit und einem Endpolierpad kann Ra 0,06 nm oder weniger erreichen.
Empfohlene Produkte und Parameter für Siliziumkarbid-Schleif-/Polierprozesse
| Verfahren | Empfohlene Produkte | Entfernungsrate | Qualität der Oberfläche | ||
|---|---|---|---|---|---|
| Polierschlämme | Polierkissen | ||||
| Endpolitur | Schleifen / Läppen | JZ-8003 | JZ-1020 | 25-30um/H | 1,22nm |
| Endpolitur | JZ-8001 | JZ-1020 | 6,8 um/H | 0,45nm | |
| Polieren | Grobpolieren | JZ-8010 | JZ-3020 | 2,5um/H | 0,13nm |
| Endpolitur | JZ-8020A JZ-8020B |
JZ-326 | 0,25 um/H | 0,06nm | |
Lagerungsmethode für JIZHI Electronics SiC Siliziumkarbid-Polierschlamm
In einem gut belüfteten, kühlen und trockenen Lagerhaus aufbewahren. Das Produkt muss bei 5-35 °C gelagert werden und vor direkter Sonneneinstrahlung und Frost geschützt werden. Bei Lagerung unter 0 °C kann es zu irreversibler Agglomeration kommen, wodurch das Produkt unbrauchbar wird.
Preisgestaltung von JIZHI Electronics CMP / Slurry Polierflüssigkeiten
Die CMP-Metallpolierschlämme von JIZHI Electronics werden mit fortschrittlichen Produktionstechnologien und -anlagen in Übersee hergestellt und mit speziellen chemischen Zusammensetzungen formuliert. Die Qualität der Polierschlämme von JIZHI Electronics ist vergleichbar mit der von ähnlichen importierten Produkten.
Dank der lokalen Produktion bieten die CMP-Slurries von JIZHI Electronics kurze Lieferzeiten, eine stabile, hohe Qualität und wettbewerbsfähige, kostengünstige Preise.
Warum Jizhi Electronics wählen?
10 Jahre Erfahrung im Bereich CMP für optische Materialien
10 Jahre Erfahrung im Bereich CMP für optische Materialien
Polierlösungen und -rezepturen werden flexibel angepasst
Ungiftige, biologisch abbaubare Formel, die den internationalen
Kostenloses Prozess-Debugging
40% schnellere Bearbeitungszeit im Vergleich zu konventionellen Produkten
Einführung ausländischer Produktionstechnologien und Ausrüstungen
Optimierte Verbrauchsrate reduziert die Gesamtbetriebskosten