半導体製造用タングステンCMPスラリー
1.タングステンCMPの紹介
タングステンの化学的機械的平坦化(CMP)は、半導体製造、特にコンタクトプラグやビアフィルプロセスにおいて重要な役割を果たしています。タングステンは、その優れた熱安定性、ポリシリコンと比較して低い抵抗率、高アスペクト比フィーチャーとの互換性により、広く使用されています。.
電気化学的酸化と不動態化ダイナミクスが支配的な銅CMPとは異なり、タングステンCMPは、主にタングステン酸化物の制御された化学溶解に依存しています。そのため、タングステンCMPスラリーの処方は、純粋に機械的な研磨よりも、化学的な速度論、酸化物の溶解度、選択性の制御に重点を置いています。.
タングステンCMPは、プロセス・ウィンドウが狭く、スラリーの化学的性質と下流の歩留まりとの間に強い相関関係があるため、プロセス・エンジニアの間では、最も化学的に敏感なCMP工程のひとつと広くみなされている。.
CMPスラリーの概念に関する基礎的な概要については、以下を参照のこと:
半導体製造用CMPスラリー
2.半導体デバイスにおけるタングステンCMPの応用
タングステンCMPは主に以下の用途で使用される:
- コンタクトプラグの平坦化
- ロジック・デバイスとメモリ・デバイスにおけるビア・フィルCMP
- ゲートコンタクトとローカル配線の平坦化
典型的な統合スタックには以下のようなものがある:
- タングステン(W)充填
- バリア層(Ti / TiN)
- 誘電体層(SiO2, ローk)
CMPプロセスは、浸食やリセスを誘発することなく、バリア層や誘電体層上で確実に停止しながら、タングステンのオーバーバードを除去しなければなりません。.
3.CMPに関連するタングステンの材料特性
タングステンの本質的な材料特性を理解することは、スラリーの設計に不可欠です。.
| プロパティ | 価値 | CMPとの関連性 |
|---|---|---|
| 融点 | 3422 °C | 高い熱安定性 |
| モース硬度 | 7.5 | 化学的軟化が必要 |
| ネイティブ酸化物 | WO3 | キー取り外し中級 |
| 酸化物溶解度 | 低い(中性pH) | 酸性スラリーの設計をドライブ |
タングステンの純粋な機械研磨は、その硬さのために実用的ではありません。効果的なCMPは、タングステン酸化物の形成と溶解に依存します。.
4.化学的・機械的除去メカニズム
4.1 タングステン表面の酸化
酸性のCMPスラリー中では、タングステンは酸化されて三酸化タングステン(WO3)を酸化剤と反応させる。.
W + 3H2O → WO3 + 6H+ + 6e-
4.2 酸化タングステンの溶解
WO3 は、中性およびアルカリ性溶液への溶解度は限定的であるが、酸性条件下では溶解度が増し、タングステン酸塩を形成する。.
4.3 機械的除去
化学的に軟化した酸化皮膜は、穏やかな研磨作用とパッドのアスペリティによって除去され、反応を継続するための新鮮なタングステン表面が露出します。.
5.タングステン CMP スラリー組成図
5.1 酸化剤
- 硝酸第二鉄(Fe(NO3)3)
- 過酸化水素(限定使用)
5.2 pH調整剤
タングステンCMPスラリーは通常、強酸性条件下で使用される。.
- 硝酸
- 有機酸
5.3 研磨システム
- ファインコロイダルシリカ
- 低研磨負荷で傷を防ぐ
5.4 阻害剤と選択性修飾剤
添加剤は、バリア層の剥離を抑制し、溶解速度を安定させるために使用される。.
6.化学反応速度論と律速段階
タングステンCMPでは、速度を制限する工程は機械的ではなく化学的であることが多い。.
- 酸化速度が最大MRRを決める
- 酸化物の溶解速度が定常状態の除去を制御する

7.工学パラメータと実験データ
| パラメータ | 典型的な範囲 | エンジニアリングの影響 |
|---|---|---|
| pH | 1.5-3.5 | 酸化物の溶解度コントロール |
| MRR | 150-400 nm/分 | スループット |
| W:酸化物選択性 | > 30:1 | ストップ・レイヤー・プロテクション |
| WIWNU | < 6% | 平面性コントロール |
8.プロセスウィンドウとコントロールマップ

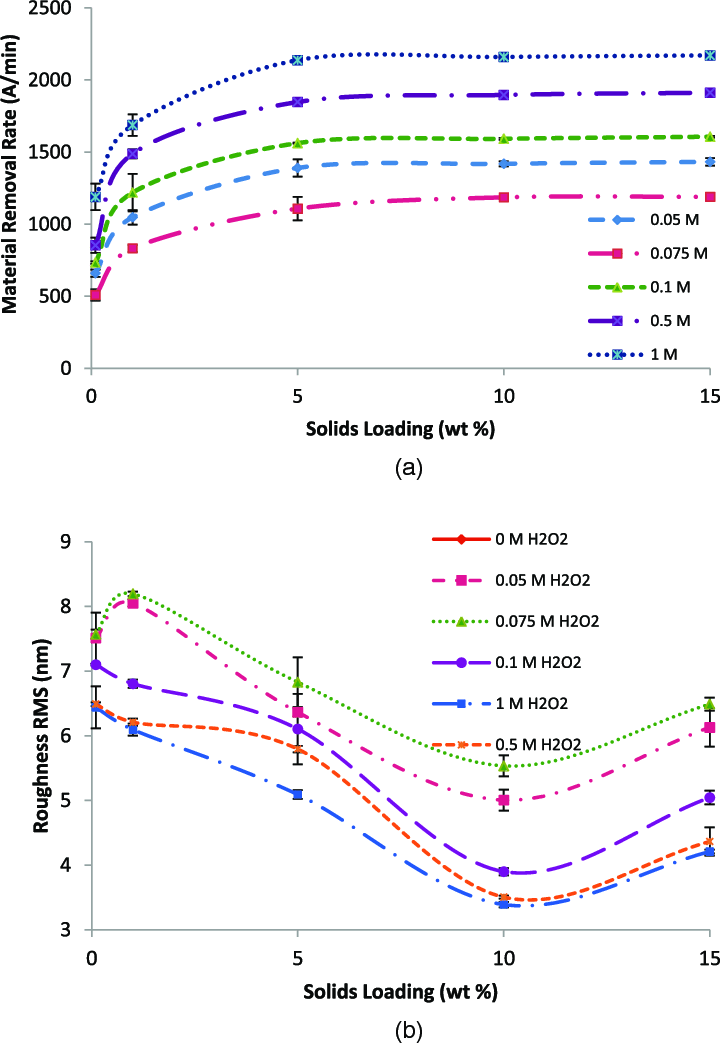
最適なタングステンCMPプロセスウィンドウは一般的に狭く、厳密な化学物質管理と強固なモニタリングが必要となる。.
9.欠陥メカニズムと根本原因分析
9.1 タングステン・リセス
過度の研磨や過度の化学溶解が原因。.
9.2 バリア層の躍進
選択性が不十分な場合に発生し、Ti/TiN層が露出する。.
9.3 パーティクルによる傷
研磨剤の凝集や不十分なろ過が原因。.
10.大量生産の課題
パイロット・スケールでは良好な性能を示すタングステンCMPスラリーも、HVMではしばしば課題に直面する:
- 再循環中の酸化剤の枯渇
- ツールランタイムの延長によるpHドリフト
- フィルター・ローディング効果
堅牢なタングステンCMPスラリーの設計は、長時間の運転条件下で安定した動力学を実証する必要がある。.
11.スラリーの選択と最適化のガイドライン
- 生のMRRよりも選択性を優先する
- 最悪のpHドリフト下でのプロセスウィンドウの検証
- スラリーの化学的性質とパッドの空隙率を一致させる
12.タングステンCMPスラリーの今後の動向
今後のタングステンCMPスラリーの開発は、以下のような要因によって推進される:
- コンタクト寸法の縮小
- 高アスペクト比構造
- 先進のロジック・ノードやメモリー・ノードとの統合