用于半导体晶片抛光的金属 CMP 泥浆
1.金属 CMP 简介
金属化学机械平坦化(CMP)是先进半导体制造中集成度最高的关键工艺之一。与介电 CMP 不同,金属 CMP 涉及电化学活性材料,其表面状态对浆料化学、氧化还原条件和机械相互作用高度敏感。.
随着设备结构向更小的几何尺寸和异质材料堆发展,CMP 泥浆必须同时满足去除率、选择性、缺陷控制和腐蚀抑制等方面的竞争要求。.
本白皮书提供了一个统一的工程框架,用于理解多种金属材料(包括铜、钨、铝、钴和新兴的钌系统)的金属 CMP 泥浆行为。.
有关 CMP 泥浆基本原理的高级概述,请参阅:
用于半导体制造的 CMP 泥浆
2.为什么金属 CMP 有本质区别
金属 CMP 与氧化物 CMP 的本质区别在于以下因素:
- 金属具有电化学反应性
- 表面钝化层动态形成和溶解
- 去除率通常受化学限制而非机械限制
在金属 CMP 中,浆料化学成分起着积极的控制作用:
- 氧化物形成动力学
- 表面腐蚀行为
- 金属与焊盘之间的界面粘附力
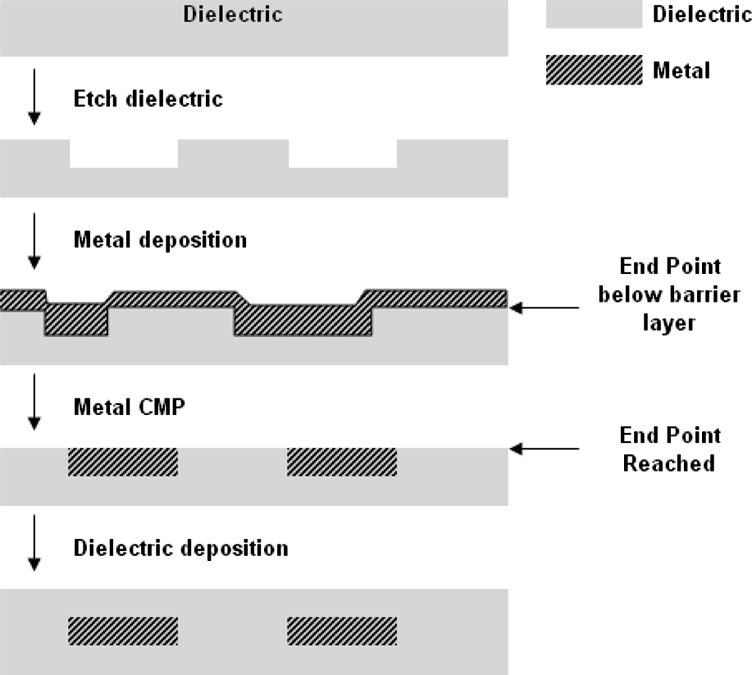
3.金属 CMP 泥浆类型的分类
金属 CMP 泥浆可从多个工程角度进行分类:
3.1 按目标金属分类
- 铜 (Cu)
- 钨 (W)
- 铝 (Al)
- 钴(Co)
- 钌 (Ru)
3.2 按化学控制模式分类
- 氧化控制泥浆
- 溶解控制泥浆
- 钝化控制泥浆
3.3 按集成敏感度分类
- 高选择性 CMP(阻挡层)
- 低缺陷 CMP(高级节点)
4.不同金属的去除机制
虽然所有金属 CMP 工艺都涉及化学和机械成分,但主要的去除机制因金属类型而异。.
| 金属 | 主导机制 | 关键化学品控制 |
|---|---|---|
| 铜 | 氧化 + 钝化 | 抑制剂吸附 |
| 钨 | 氧化 + 溶解 | pH 值和氧化剂动力学 |
| 铝质 | 氧化物磨损 | 原生氧化物稳定性 |
| 钴 | 受控腐蚀 | 氧化还原平衡 |
| 钌 | 表面活化 | 催化氧化 |
5.金属 CMP 泥浆成分结构
5.1 研磨系统
- 胶体二氧化硅(缺陷风险低)
- 氧化铝(硬度高,划伤风险较高)
- 混合磨料系统
5.2 氧化剂
- 过氧化氢
- 铁盐
- 过硫酸盐(高级金属)
5.3 复配制剂
络合剂可稳定溶解的金属离子,防止重新沉积。.
5.4 抑制剂和缓蚀剂
对于铜、钴和钌 CMP 而言,防止电化学腐蚀至关重要。.
6.金属专用 CMP 泥浆的注意事项
6.1 CMP 铝浆
铝的 CMP 依赖于去除 Al2O3 通常需要仔细控制磨料硬度。.
6.2 钴 CMP 泥浆
钴 CMP 泥浆必须兼顾高化学反应性和腐蚀抑制性。.
6.3 钌 CMP 泥浆
由于其催化表面行为,钌 CMP 是最具挑战性的新兴金属 CMP 系统之一。.
7.工程参数和实验数据
| 参数 | 典型范围 | 工程影响 |
|---|---|---|
| pH 值 | 2.0-7.0 | 取决于金属的稳定性 |
| MRR | 100-800 纳米/分钟 | 吞吐量与控制 |
| 选择性 | > 20:1 | 屏障保护 |
| 划痕密度 | < 0.1 / 晶圆 | 产量 |
8.流程窗口与集成控制
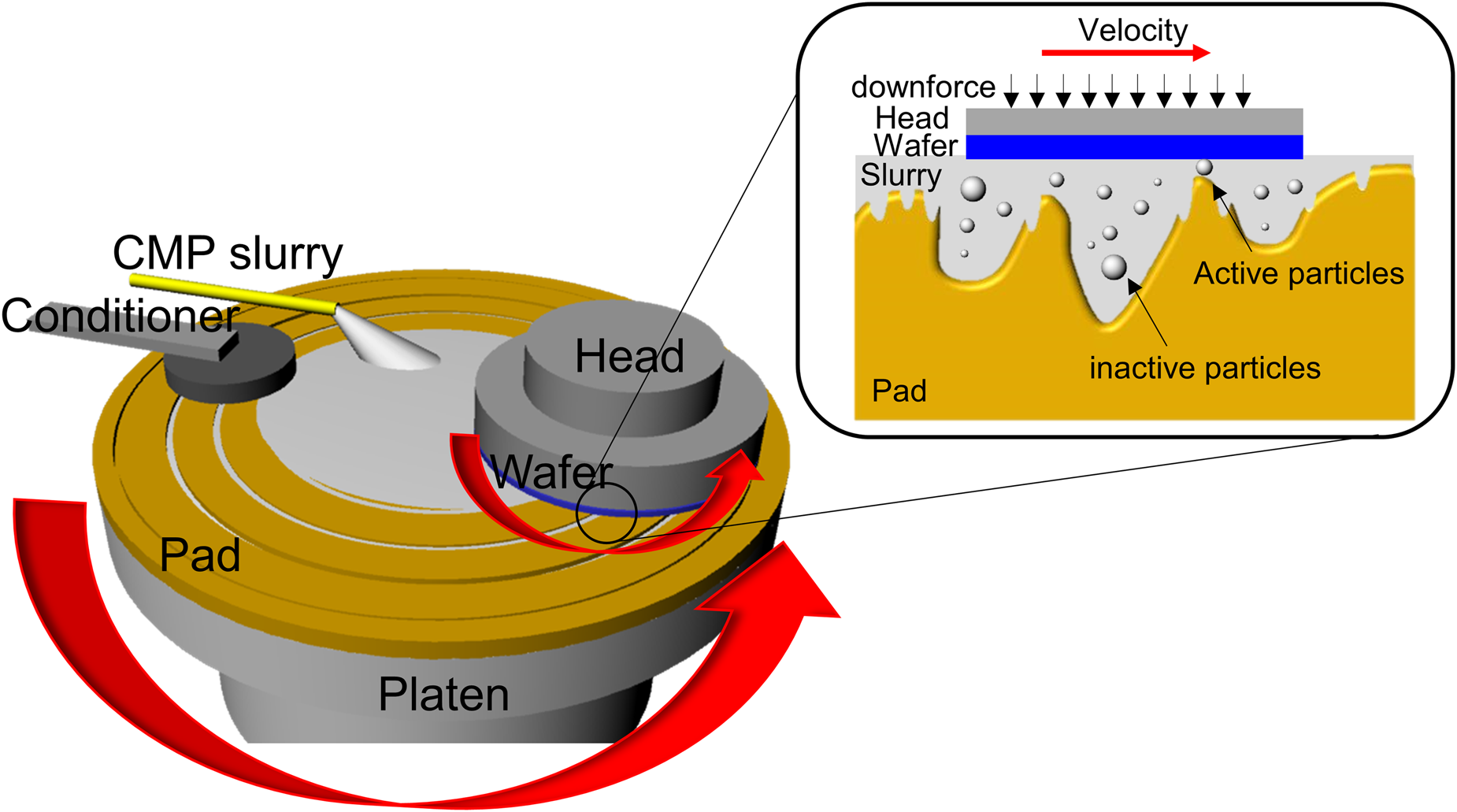
金属 CMP 工艺窗口通常比氧化物 CMP 更窄,需要更严格的化学和机械控制。.
9.金属 CMP 缺陷及根源分析
9.1 挖掘和侵蚀
由于金属和周围电介质的去除率不匹配而产生。.
9.2 腐蚀和点蚀
原因是氧化剂浓度过高或抑制剂覆盖面不足。.
9.3 微粒引起的划痕
与磨料结块或过滤效率低下有关。.
10.大批量生产面临的挑战
金属 CMP 泥浆面临着独特的 HVM 挑战:
- 再循环过程中的化学消耗
- 衬垫老化效果
- 工具与工具之间的差异
泥浆配方必须证明在长时间运行条件下的稳定性。.
11.金属 CMP 的浆料选择策略
- 确定主要清除机制
- 定义选择性优先级
- 验证腐蚀余量
有关特定金属的指导,请参见
12.金属 CMP 泥浆的未来趋势
未来金属 CMP 泥浆的开发重点是:
- 用于高级互连器件的替代金属
- 5 纳米以下节点的缺陷率较低
- 环境可持续化学