




切割刀片
HD25、 HS25 、 E25
目前,我们有三个系列的切割刀片:HD25、HS25 和 E25 适用于加工各种硬脆材料,如半导体晶片、封装基板、LTCC、PZT 和 TGG。.
主要功能
- 适用于各种化合物晶片。.
- 适用于硬脆材料。.
产品名称
HD25、 HS25 、 E25
产品介绍
我们目前提供三个系列的切割刀片--HD25、HS25 和 E25,适用于加工半导体晶片、封装基板以及 LTCC、PZT 和 TGG 等各种硬脆材料。我们的团队掌握了精密电镀、磨料粒度控制和超精密加工等关键技术,使我们的刀片在国内市场处于领先水平。.
包装和测试过程
产品介绍 HD25

HD25 系列硬切割刀片具有加工精度高、切口窄的特点。它们适用于加工硅晶片、氧化物晶片和各种化合物晶片,如碳化硅 (SiC)、砷化镓 (GaAs) 和磷化镓 (GaP)。.
规格示例:HD25 CB 3000N 70
| 叶片曝光量(微米) | 角宽度(微米) | 粒度(目数) | 粘接剂 | 体积浓度 | ||||
|---|---|---|---|---|---|---|---|---|
| Z | 250-380 | Z | 11-15 | 5000 | 2500 | S | 锋利型 | 50 |
| A | 380-510 | A | 16-20 | 4800 | 2000 | N | 通用型 | 70 |
| B | 510-640 | B | 20-25 | 4500 | 1800 | H | 高强度型 | 90 |
| C | 640-760 | C | 25-30 | 4000 | 1700 | 110 | ||
| D | 760-890 | D | 30-35 | 3500 | 1500 | 130 | ||
| E | 890-1020 | E | 35-40 | 3000 | 1000 | |||
| F | 1020-1150 | F | 40-50 | |||||
| G | 1150-1270 | G | 50-60 | |||||
产品介绍 HS25

HS25 系列硬质切割刀片具有出色的耐磨性和更高的边缘稳定性,可有效控制芯片的侧壁台阶,确保芯片尺寸的一致性。它们适用于 LED 陶瓷基板、半导体封装基板以及 PZT 和 TGG 等硬脆材料。.
规格示例:HS25 58 ×4.0 ×0.2B 400S30S48
| 外径(毫米) | 曝光(毫米) | 厚度(毫米) | 厚度公差(毫米) | 粒度(目数) | 粘接剂 | 体积浓度 | 插槽数量 | |||||
|---|---|---|---|---|---|---|---|---|---|---|---|---|
| 56 | 2.0 | 3.4 | 0.06 | 0.20 | A | ±0.005 | 1200 | S | 锋利型 | 30 | S16 | 16 |
| 58 | 2.2 | 3.6 | 0.08 | 0.22 | B | ±0.010 | 1000 | N | 通用型 | 50 | S32 | 32 |
| 2.4 | 3.8 | 0.10 | 0.24 | C | ±0.015 | 800 | H | 高强度型 | 70 | S48 | 48 | |
| 2.6 | 4.0 | 0.12 | 0.26 | 600 | 90 | |||||||
| 2.8 | 4.2 | 0.14 | 0.28 | 500 | 110 | |||||||
| 3.0 | 4.4 | 0.16 | 0.30 | 400 | 130 | |||||||
| 3.2 | 4.6 | 0.18 | 0.32 | 340 | 150 | |||||||
产品介绍 ES25

ES25 系列软切割刀片的切割速度最高可达 200 mm/s,使用寿命超过 7,000 米,适用于 PCB 基板、EMC 基板、芯片 LED 基板以及 LTCC、PZT 和 TGG 等硬脆材料。.
规格示例:E25 56 ×0.08B ×40 800H130S16
| 外径(毫米) | 厚度(毫米) | 厚度公差(毫米) | 内径(毫米) | 粒度(目数) | 粘接剂 | 体积浓度 | 插槽数量 |
|---|---|---|---|---|---|---|---|
| 50 | 0.02 | P ±0.003 | 40 | 1200 | S - 锐利型 | 30 | S16 (16) |
| 52 | 0.04 | A ±0.005 | 1000 | N - 通用型 | 50 | S32 (32) | |
| 54 | 0.06 | B ±0.010 | 800 | H - 高强度型 | 70 | S48 (48) | |
| 56 | 0.08 | C ±0.015 | 600 | 90 | |||
| 58 | 0.10 | 500 | 110 | ||||
| 59 | 0.12 | 400 | 130 | ||||
| 0.14 | 340 | 150 |
优势-1

金刚石微粉的粒度分布极窄,晶体形态经过严格控制,高度均匀,确保了出色的加工质量。.
优势-2
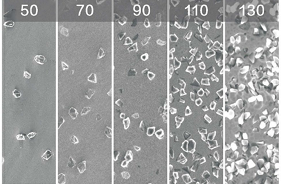
金刚石浓度的序列化和精确分级控制确保了加工质量(尤其是减少背面崩角)和刀具寿命之间的最佳平衡。.
优势-3
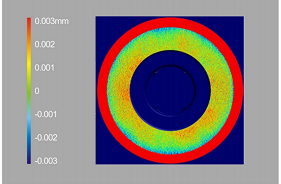
轮毂和刀片边缘的制造精度极高,缩短了预切割时间,并将高速旋转时的刀片振动降至最低。.
优势-4

刀刃具有出色的耐腐蚀性,适用于 CO₂ 切割环境,并能延长刀片的整体使用寿命。.
优势-5

切口宽度极窄,最小可达 10 微米,可满足 GaAs LED 等窄晶圆的切割要求。.
优势-6
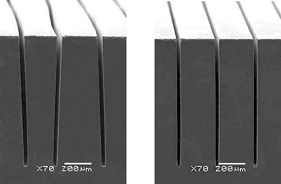
刀片具有极高的刃口强度,可在主轴高速运转时防止蛇形切削,并在切屑上保持良好的侧壁垂直度。.
服务承诺
- - 对于 500 片以下的订单,7 个工作日内发货。.
- - 协助客户选择刀片和开发新的切割工艺。.
- - 提供免费测试样品。.
- - 8 小时内提供快速服务响应;48 小时内提供现场支持。.
- - 技术交流和定期后续访问。.
- - 就任何与质量有关的问题提供 8D 报告。.
为什么选择集智电子?
10 年光学材料 CMP 经验
10 年光学材料 CMP 经验
抛光方案和配方可灵活定制
无毒、可生物降解配方,符合国际环保标准。
免费进程调试
40% 的处理时间比传统方法更快a
引进国外生产技术和设备
优化的消耗率降低了总体运行成本。